La première photo d'un die Lakefield, avec Sunny Cove et Tremont monté en 3D à la Foveros ? |
————— 14 Mars 2020 à 17h26 —— 15171 vues
La première photo d'un die Lakefield, avec Sunny Cove et Tremont monté en 3D à la Foveros ? |
————— 14 Mars 2020 à 17h26 —— 15171 vues
Tout d’abord, les présentations usuelles pour replacer tout ce monde dans son contexte. Foveros est une nouvelle technologie de puce « 3D » qui devrait faire ses débuts très prochainement chez Intel, et dont le fondeur avait causé plus ou moins en détail en tête à tête avec le Comptoir lors de son Architecture Day fin 2018. La plateforme Lakefield devrait être la première déclinaison commerciale à profiter de la technologie, elle avait été mentionnée à l’Architecture Day, mais aussi au CES 2019, où Intel avait présenté ses bonnes résolutions pour le grand public.
En tout cas, le premier usage commercial de Foveros se ferait sous la forme d’une nouvelle petite puce hybride 12 x 12 mm composée de 4 cœurs Atom Tremont (une nouvelle microarchitecture succédant à Goldmon Plus des Celeron et Pentium Silver), d’un cœur Sunny Cove (la nouvelle grande révision microarchitecturale de Core après Skylake), et d’une puce graphique intégrée Gen11 (aussi nommée Iris Plus Graphics, introduite en 2019 avec Ice Lake).
L’année dernière, Intel avait communiqué sur le début de la production en masse au courant de la même année, on attend toujours des nouvelles plus concrètes, mais la fuite de cette capture présumée d’un die de Lakefield prouve peut-être que l’on se rapproche tout doucement d’un lancement commercial. Bien sûr, il faut prendre l’image pour ce qu’elle est, une capture repérée sur Imgur par un utilisateur du forum d’AnandTech.
En attendant, celle-ci nous montrerait les entrailles d’une puce Lakefield de 82 mm², soit la largeur d’un Broadwell-Y 14 nm dual core. La partie verte visible au centre serait la portion Tremont du die, sur une surface 5,1 mm², la partie sombre située en dessous représenterait le core Sunny Cove. Le GPU Gen11 situé à droite avec tous ses composants (médias et moteurs d’affichage) occuperait visiblement près de 40 % du die, on remarque aussi la présence de DRAM PoP (package-on-package) dans la partie supérieure.
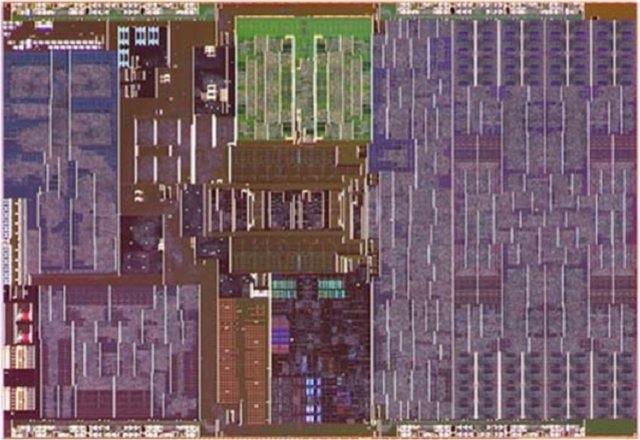
Un tel assemblage aussi dense sur une surface réduite est donc rendu possible par la technologie Foveros et sa nouvelle technique de structure tridimensionnelle (une conception verticale plus 2.5D que 3D), ayant ici pour base un die 22FFL (22 nm, FinFET Low-power) sur lequel sont collés les puces 10 nm Sunny Cove et Tremont, le tout connecté via l’interposer « 2.5D » Foveros. La tablette pliable ThinkPad X1, présentée par Lenovo au CES 2020, serait a priori parmi l’une des premières machines à exploiter la nouvelle solution d’Intel, ainsi que la nouvelle version Windows 10X de l’OS de Microsoft.
 | Un poil avant ?Der8auer présente ses brackets spéciaux "overclocking" pour Ryzen 3000 | Un peu plus tard ...TSMC : le 5 nm à l'heure pour avril et déjà entièrement réservé |  |